随着信息产业的不断发展与芯片制程工艺的不断进步,微电子器件逐渐小型化、集成化和高功率化,散热问题成为制约微电子器件进一步发展的瓶颈。传统的电子封装材料由于较低的热导率(< 300 W m-1 K-1)已经不能满足高功率电子器件的散热需求,急需开发新一代具有高热导率和低热膨胀系数的电子封装材料。近年来,金刚石颗粒增强铝基(diamond/Al)复合材料具有较高的热导率、可调控的热膨胀系数和较低的密度,吸引了研究者的广泛关注。目前,diamond/Al复合材料热导率的最高值仅为770 W m-1 K-1,未能充分利用金刚石的高导热特性,如何进一步提高diamond/Al复合材料的热导率,是本领域主要解决的关键问题。
近日,北京科技大学张海龙教授与西安交通大学武海军教授、北京航天航空大学赵立东教授合作,通过实现高界面热导、大粒径金刚石颗粒、高金刚石体积分数和高致密度的同时优化,获得热导率高达1021 ± 34 W m-1 K-1的diamond/Al复合材料(图1),为目前报道金刚石颗粒增强金属基复合材料热导率的最高值,研究成果以题为Realizing ultrahigh thermal conductivity in bimodal-diamond/Al composites via interface engineering发表在Materials Today Physics(2022, 28, 100901)。
论文链接: https://doi.org/10.1016/j.mtphys.2022.100901

研究工作采用双粒径金刚石颗粒提高金刚石体积分数并实现大粒径金刚石颗粒的致密化制备,通过优化非连续原位碳化物界面层提高界面热导(图2),利用多因素的协同作用,在diamond/Al复合材料的热导率方面取得突破。该复合材料同时具有与半导体材料匹配的低热膨胀系数(3.40 × 10-6 K-1)、较高的高温热导率和稳定的热循环性能(图3),能够对高功率微电子器件进行有效散热,有望替代现有电子封装材料,推动电子封装技术的发展。
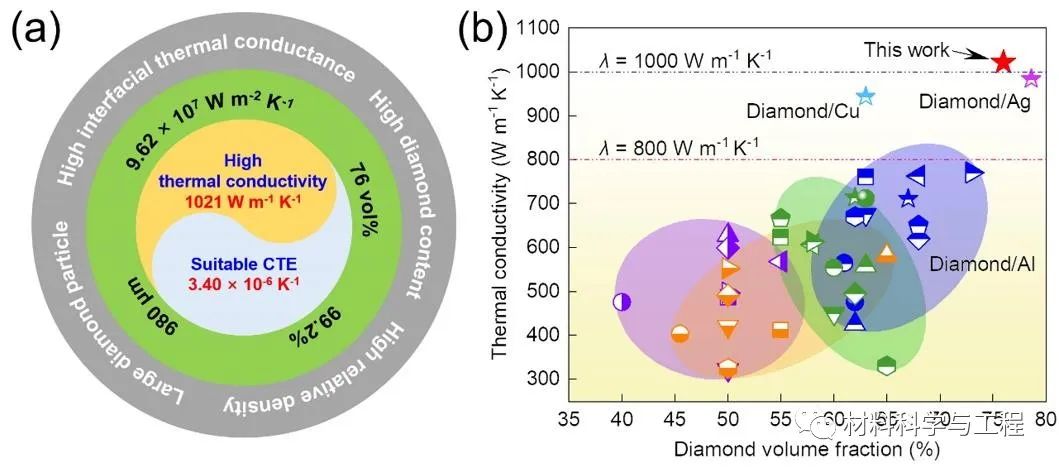
图1. (a) Diamond/Al复合材料实现优异热物理性能的策略:同时实现高界面热导、大粒径金刚石颗粒、高金刚石体积分数和高致密度的优化;(b) 热导率与文献对比。
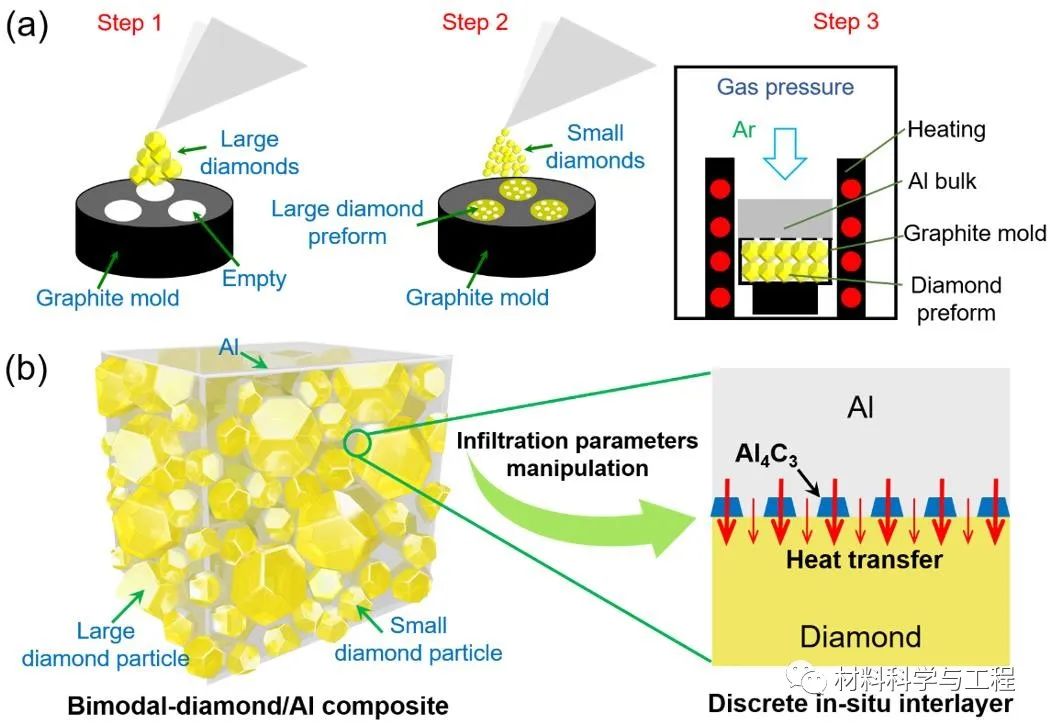
图2. Diamond/Al复合材料同时实现高界面热导、大粒径金刚石颗粒、高金刚石体积分数和高致密度的优化方 案:(a) 双粒径金刚石颗粒提高金刚石体积分数并实现大粒径金刚石颗粒的致密化制备;(b) 非连续Al4C3界面层实现高界面热导。
案:(a) 双粒径金刚石颗粒提高金刚石体积分数并实现大粒径金刚石颗粒的致密化制备;(b) 非连续Al4C3界面层实现高界面热导。
图3. Diamond/Al复合材料的热物理性能:(a) 不同粒径金刚石颗粒制备的复合材料的热导率;(b) 298-673 K范围内热膨胀系数与半导体材料GaN、金属Al、金刚石对比;(c) 比密度热导率与diamond/Cu、diamond/Ag复合材料、高导热金属对比;(d) 高温热导率与diamond/Cu复合材料、金属Cu和Al对比;(e) 热导率随218-423 K温度范围热循环次数的变化。
免责声明:本网站所转载的文字、图片与视频资料版权归原创作者所有,如果涉及侵权,请第一时间联系本网删除。

官方微信
《腐蚀与防护网电子期刊》征订启事
- 投稿联系:编辑部
- 电话:010-62316606-806
- 邮箱:fsfhzy666@163.com
- 腐蚀与防护网官方QQ群:140808414





