基于环氧树脂的底部填充(Underfill)工艺是当前的主要封装技术,其中Underfill材料用于填充倒装芯片(Flip chip)与印制电路基板(PCB)之间的空隙(间距 100 μm),在封装体系中主要起到分散焊点热应力、为芯片提供物理保护的作用,是确保封装体系可靠性的关键。近年来,集成电路芯片的高集成化导致其热功率密度急剧升高,有效散热成为保证电子设备稳定性和可靠性的重要因素。理想的高性能Underfill材料应具备以下性能:低黏度( 20 Pa·s,25 ℃)、合适的热膨胀系数(25-30 ppm/℃)、高电绝缘性(体积电阻> 1012 Ω·cm)、高导热性能( 1 W·m-1·K-1)以及良好的热稳定性(Tg 125 ℃)与介电性能等。然而,环氧树脂的低导热性限制了高性能Underfill材料的发展。尽管已有大量关于提高环氧树脂基复合材料导热性能的研究工作,但其设计策略鲜有考虑对体系流动性、电绝缘性、热性能、介电性能等性能的综合影响。设计、制备能同时满足Underfill材料所需综合性能的环氧树脂基复合材料存在性能间的博弈、需要取得平衡,实现Underfill材料加工流动性、导热性、绝缘性、热性能、介电性能等结构功能的一体化设计是电子封装材料领域的重要科学问题。
近期,华中科技大学解孝林教授团队与澳大利亚悉尼大学米耀荣院士团队合作以“Advances on thermal conductivity epoxy-based composites as electronic packaging underfill materials - A review”为题在《Advanced Materials》上发表了综述,介绍了现阶段改善Underfill分散体系粘度、提高Underfill材料热导率的策略,讨论了这些策略的应用对Underfill用环氧树脂基复合材料综合性能的影响,指出了该领域所面临的机遇和挑战,为实现底部填充电子封装材料的高性能化、多功能化和低成本化提供了新思路和新角度。

【改善Underfill用环氧树脂分散体系的流动性】
填料的含量、形状和粒径分布的影响:(1)填充相同粒子,分散体系黏度与填充量正相关;(2)在相同填料含量下,球形粒子分散体系的黏度低于非球形粒子;(3)将小尺寸粒子与大尺寸粒子级配,可提高填充体系的理论最大堆积密度,因此在相同的填充量时,可降低填料的拥挤程度,有利于改善高填充复合体系的加工流动性。解孝林团队研究了二元球形粒子的理论堆积密度与粒径比、小粒径填料体积占比的关系,研究结果表明在最大堆积密度配比附近,二元氧化铝微球分散体系黏度最低。
填料的表面修饰:在纳米填料表面修饰合适的官能团,能够改善填料-基体的界面相互作用及其分散性,改善分散体系的加工黏度。解孝林团队在碳纳米管表面接枝具有柔性长链的有机分子,利用长链分子的隔离作用及良好的流动性使填料类流体化,改善了碳纳米管在环氧树脂中的分散性,降低复合体系的加工黏度。
【提高Underfill用环氧树脂基复合材料的热导率】
为解决碳纳米管、银纳米线等高导热填料在环氧树脂基复合材料中的电绝缘性不足问题,解孝林团队采用无机氧化物(如二氧化硅、二氧化钛)或有机聚合物(如聚氨酯)等进行表面包覆,实现导热填料的电绝缘化。在碳纳米管或银纳米线等表面包覆二氧化硅,不仅赋予导热填料良好的电绝缘性,还能缓解导热填料与聚合物基体之间的模量失配,促进界面声子共振耦合,显著提升复合材料的导热性能,解决高导热与电绝缘之间的矛盾。
此外,通过对导热填料进行共价修饰,可强化填料与聚合物的界面相互作用,降低界面热阻、提高复合材料热导率。通过对填料的合理设计,如:优化填料尺寸和形貌、改善填料分散性、选用多元杂化填料、降低填料间的接触热阻,可构筑高效的导热通路,也能提高复合材料热导率。
【Underfill用环氧树脂基复合材料的综合性能】
基于现阶段的降低黏度、提高热导率策略,作者选取了六类具有代表性的环氧树脂基Underfill材料,从热导率、黏度、电阻率、热膨胀系数、玻璃化温度以及相对成本角度比较了其综合性能(图1),并强调了其中几种具有代表性的设计策略(图2)。
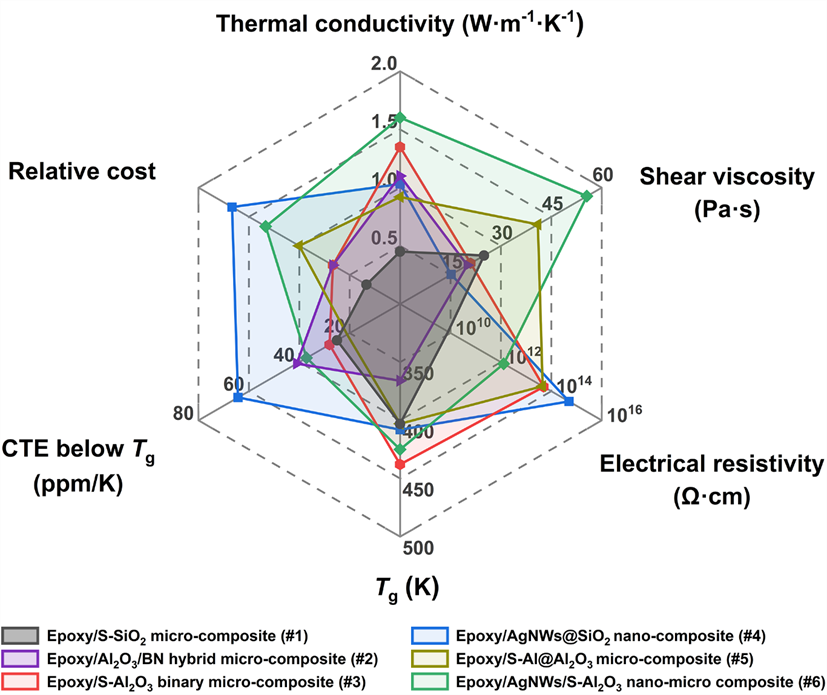
图1 Underfill用环氧树脂基复合材料的综合性能:环氧树脂/二氧化硅微球复合材料(#1)、环氧树脂/氧化铝微球/氮化硼微片复合材料(#2)、环氧树脂/二元氧化铝微球复合材料(#3)、环氧树脂/二氧化硅包覆银纳米线复合材料(#4)、环氧树脂/氧化铝包覆金属铝微球复合材料(#5)、环氧树脂/银纳米线/氧化铝微球复合材料(#6)

图2 Underfill用环氧树脂基复合材料的填料设计策略:(a)高填充二元球形微米粒子,(b)高导热、电绝缘纳米填料,(c)纳米-微米杂化填料
【总结与展望】
设计满足高集成度电子封装体系散热需求的Underfill材料不仅需要考虑材料导热性能,还需考虑其加工黏度、热膨胀系数、电绝缘性、玻璃化温度、机械性能以及介电性能等,制备兼具上述综合性能的Underfill材料充满挑战。此外,制造成本以及是否易于规模化生产也是Underfill材料在实际应用前需要考虑的问题。基于此,作者从高性能化、多功能化和低成本化角度对导热型环氧树脂基Underfill材料做出总结和展望:
(1)填料的形貌、尺寸、粒径分布是影响其分散体系黏度及其复合材料热导率、热膨胀系数的重要因素,选择合适杂化或级配体系值得进一步探索。
(2)构建核-壳结构可实现高导热填料的电绝缘化,其复合材料兼具良好的导热性能和电绝缘性,但包覆改性会提高体系黏度,这类材料的高昂成本也限制了其应用。
(3)合适的填料表面修饰不但能够改善分散体系流动性,还能提高复合材料热导率、降低热膨胀系数、增强阻燃性或改善介电性能,不恰当的表面修饰则会导致材料部分性能的衰减。因此,表面修饰对Underfill材料综合性能的影响值得深入研究。
(4)目前,实现高导热填料的低成本化和规模化生产尚需学术界和产业界的共同努力。已实现商业化的氧化铝、氮化硼、氮化铝等微米填料成本相对低廉,其环氧树脂复合材料在电子封装材料上具有广阔的应用前景。其中,环氧树脂/二元氧化铝微球复合材料是极具潜力的导热型Underfill材料。
(5)高性能Underfill材料还需具备良好的阻燃性能、介电性能,但目前相关工作较少、有待进一步探索。
(6)环氧树脂自身的性能也是决定其Underfill材料性能的重要因素,通过对环氧树脂进行分子设计或基团改性,能够其增强导热性能、降低黏度、改善尺寸稳定性、提高阻燃性能、改善介电性能或赋予自修复特性,相关研究值得进一步探索。
(7)发展和应用多尺度分析模型和/或计算机模拟技术,将有助于理解Underfill材料结构与性能间的关系。
免责声明:本网站所转载的文字、图片与视频资料版权归原创作者所有,如果涉及侵权,请第一时间联系本网删除。

官方微信
《腐蚀与防护网电子期刊》征订启事
- 投稿联系:编辑部
- 电话:010-62316606-806
- 邮箱:fsfhzy666@163.com
- 腐蚀与防护网官方QQ群:140808414





